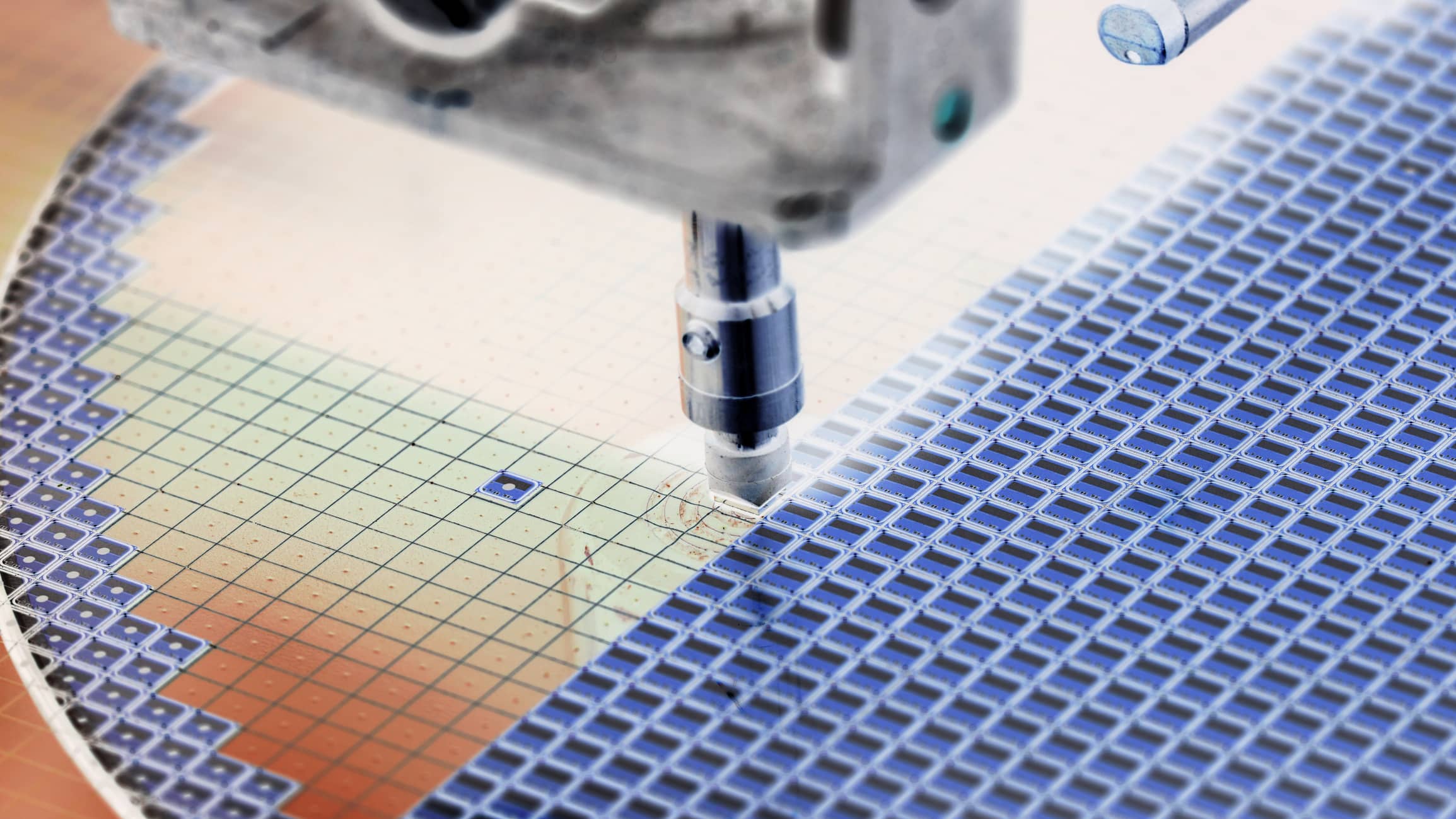
Dry Etch Processing at a MEMS Foundry that Understands Device Fabrication
Rogue Valley Microdevices provides precision dry etching for silicon wafers, MEMS devices, and semiconductor thin films. Our engineers work closely with customers to select the right etch chemistry, mask materials, and process conditions for each application.
Because our dry etch tools operate within a full MEMS foundry environment, customers gain access to production-grade wafer processing that supports both device development and manufacturing.
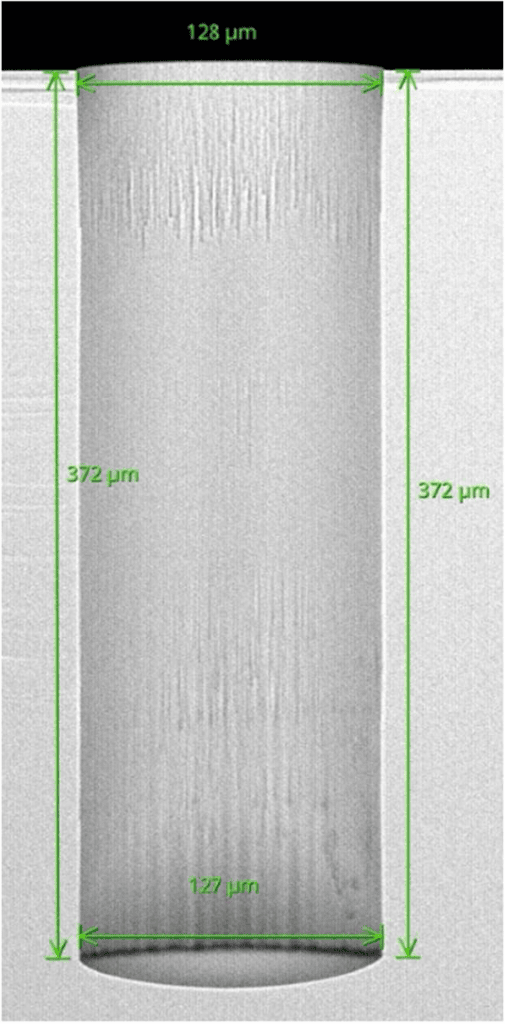
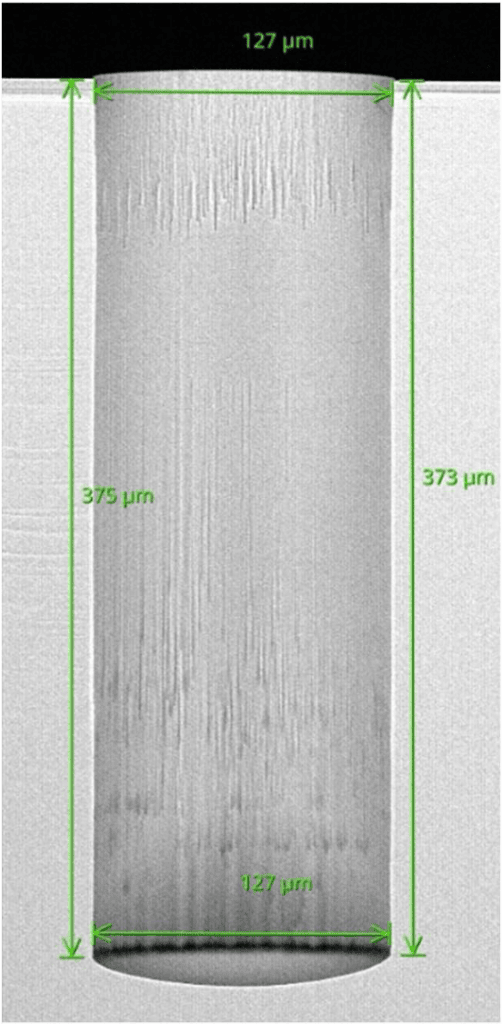
Center of 200mm Silicon Wafer
Edge of 200mm Silicon wafer
Deep Reactive Ion Etching (DRIE) for Silicon MEMS Structures
Deep Reactive Ion Etching (DRIE) enables high-precision silicon etching for MEMS device fabrication. This technology allows engineers to form deep trenches and cavities while maintaining steep sidewalls and tight dimensional control.
Our DRIE capabilities support:
- High aspect ratio silicon etching
- Deep trenches and microcavities
- Vertical sidewall profiles
- Controlled feature dimensions across wafers
DRIE silicon etching enables the fabrication of complex MEMS device structures such as:
- Pressure sensor cavities
- Microfluidic channels
- Suspended mechanical structures
- MEMS actuators and resonators
- Optical MEMS components
These silicon etch processes can be combined with allow engineers to create the three-dimensional microstructures that define MEMS device performance.
Advanced MEMS Applications
Dry etching technologies enable the fabrication of microstructures used across many MEMS and semiconductor devices. Engineers rely on plasma etch and DRIE processes to shape materials with the accuracy required for advanced microtechnology.
Common applications include:
- MEMS pressure sensors
- Accelerometers and inertial sensors
- Microfluidic devices
- RF MEMS switches
- Optical MEMS structures
- Silicon microcavities and trenches
By combining thin-film plasma etching with deep silicon DRIE capabilities, Rogue Valley Microdevices helps engineers fabricate the structures that power modern MEMS devices.
Dry Etch for Silicon, Thin Films and Dielectric Layers
Dry etching enables engineers to shape silicon wafers and thin films with the precision required for modern MEMS fabrication and semiconductor device manufacturing. At Rogue Valley Microdevices, our MEMS foundry performs advanced plasma dry etch and deep reactive ion etch (DRIE) processes that define the microstructures used in MEMS sensors, microfluidic devices, and semiconductor components. Dry etch can be provide as a wafers service or fully integrated into a device fabrication process.
Engineers use dry etching to create trenches, cavities, vias, and patterned thin films across silicon wafers. Our foundry maintains plasma etch tools and deep silicon etching processes as a core capability, enabling high-aspect-ratio MEMS structures and precision wafer processing.
All dry etch wafer services run in-house on the same equipment used to fabricate MEMS and sensor devices, ensuring reliable process integration and consistent wafer-level results.
Dry Etch for MEMS and Sensor Manufacturing
Rogue Valley Microdevices performs dry etching inside an active MEMS manufacturing environment, not a standalone wafer service facility. Our plasma etch and DRIE processes support real MEMS fabrication programs and operate within fully integrated device process flows.
Engineers benefit from:
- Foundry-grade etch equipment
- Proven MEMS fabrication processes
- Experienced process engineering support
- Reliable wafer handling and process control
- Consistent wafer-level etch uniformity
Because these etch technologies support MEMS production workflows, customers gain access to processes already validated in device manufacturing environments.
Plasma Etching for Thin Films and Dielectric Layers
Plasma etching removes material through a controlled combination of reactive gas chemistry and ion bombardment. This technique allows engineers to pattern dielectric films and functional layers while maintaining tight control of etch rates and feature dimensions.
Our plasma dry etch processes support many materials used in MEMS fabrication, including:
- Silicon dioxide (SiO₂)
- Silicon nitride (Si₃N₄)
- Silicon oxynitride
- Titanium nitride (TiN)
- Niobium thin films
Fluorine-based plasma chemistries provide high selectivity and clean etch profiles when processing dielectric films deposited through PECVD, LPCVD, and thermal oxidation processes. Plasma etch can be also be combined with wet etch techniques for optimal results during MEMS fabrication.
Plasma dry etching plays a key role after photolithography patterning, where patterned photoresist masks define the areas of material removal. This integration allows engineers to create precise device features across silicon wafers.